ICパッケージの寸法測定

加速する半導体の高機能化により、急速に高密度で3次元化が進んでいるICパッケージング技術。新東の寸法測定技術は、最先端の高密度化したFC-BGAに代表されるICパッケージ基板の製造工程に応用されています。
FC-BGAパッケージの測定
測定概要
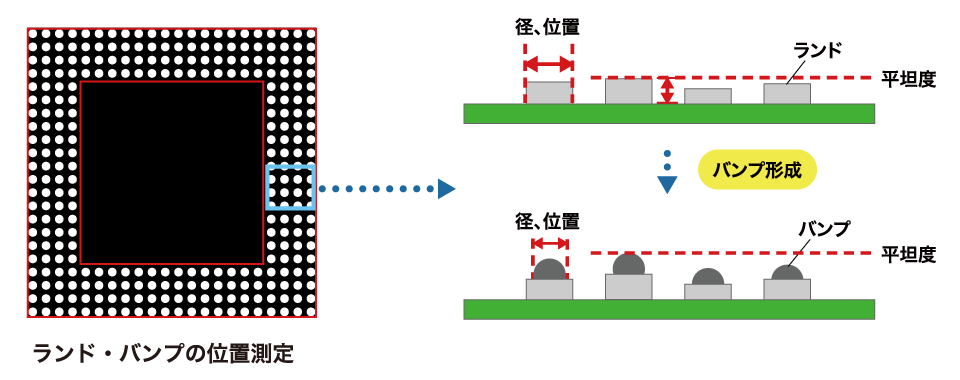
主にBGA基板とIC側または外部との電気接続部の測定を行います。バンプによる接続をするエリアでは位置・径の測定に加え、バンプ高さの均一性が重要となるため、オプションの高さ測定センサーを用いて、バンプ形成前のランド高さ、及びバンプ形成後のバンプ高さの均一性(コプラナリティー)測定を行います。
リードフレームの測定
ICパッケージでは、ICと外部との接続を仲介する部品として金属の薄板を加工したリードフレームという部品が使用されています。特にIC側との接続部であるインナーリードは年々微細化が進み、その測定の重要性が高まっています。
測定概要
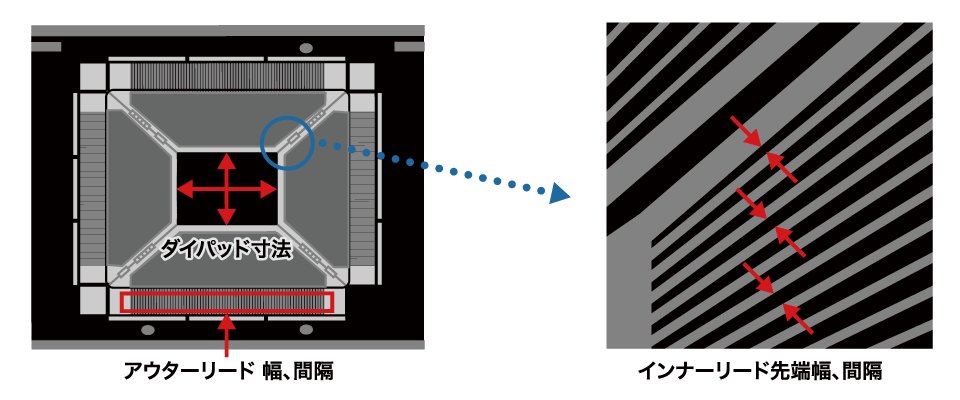
主にインナーリードやアウターリード幅、間隔、IC搭載部(ダイパッド部)の寸法などを測定します。特にインナーリードの測定では専用の測定プログラムにより、ユーザーの要求する箇所位置での幅、間隔の測定を可能にします。
フォトマスクの測定
高密度パッケージ部品のパターン形成には、ガラスの原版をもとにパターンを焼き付けて形成するフォトリソグラフィー技術が用いられ、原版として主に使用されるフォトマスクのパターン位置測定、パターンの幅、間隔、径などの測定を行います。オプションソフトウェア「C-Auto」によりパターンの設計データであるCADデータを元に測定プログラムの作成が行え、作業を効率化できます。
SP事業部 営業グループ
受付時間/月~金 9:00~12:00、13:00~17:00(祝祭日・弊社休日を除く)