精密高さ測定機 PHM-400
「PHM-400」は、半導体部品に求められる高い加工精度に対して、様々なニーズに応じた高さ測定が可能な精密高さ測定機です。
精密高さ測定機「PHM-400」では、用途に合わせて2パターンの測定機能を搭載しています。
- 【精密高さ測定機能】
- 「3Dセンサ」によってナノメートルレベルの高さ測定を非接触で高速かつ高精度に行います。
詳しく知る
- 【フィルム透過高さ測定機能】
- 「3Dセンサ」に加え、ドライフィルムレジスト(ドライフィルム)等の厚みを測定する「膜厚センサ」を搭載したデュアルセンサによる複合測定です。貼付したドライフィルム越しに±0.1mm以下の精度で溝・エンボス等の高さを測定します。
詳しく知る
従来の他測定手法では困難なΦ300mm以上の大型製品にも対応可能です。
測定工程の自動化が可能なため、目視での測定作業や再マスキング、再パターニングが不要となり、作業時間の大幅削減と仕上がり品質の安定化を実現します。
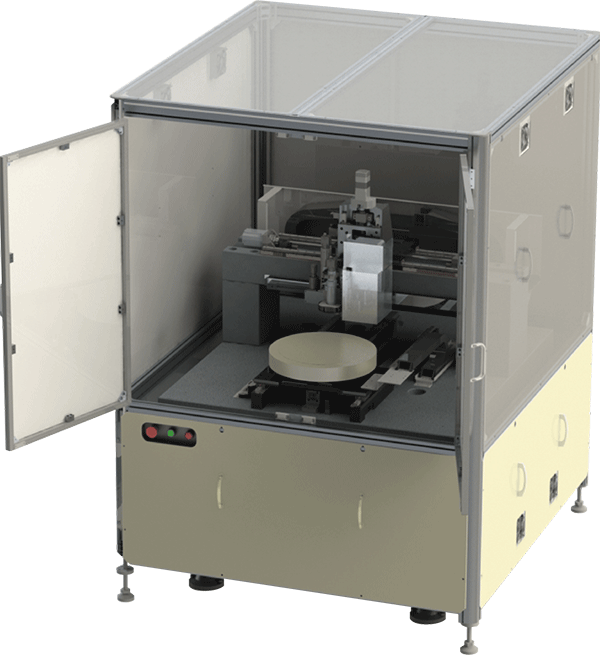
高さ測定機能
「3Dセンサ」によってナノメートルレベルの高さ測定を非接触で高速かつ高精度に行います。
測定精度
- 高さ測定繰り返し性:3σ≦0.05μm ※10μmセラミック段差ゲージ測定時
- 高さ測定精度:±0.1μm ※10μmセラミック段差ゲージ測定時
特長
- 繰り返し精度の高い測定技術により、安定的な精密高さ測定が可能
- 指定エリア面内すべての高さ情報を平準化し、点・線ではない面での測定が可能
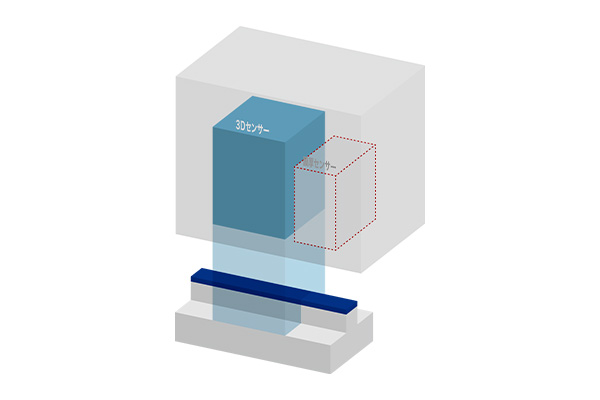
高さ測定例
半導体パッケージ基板におけるバンプ高さ測定
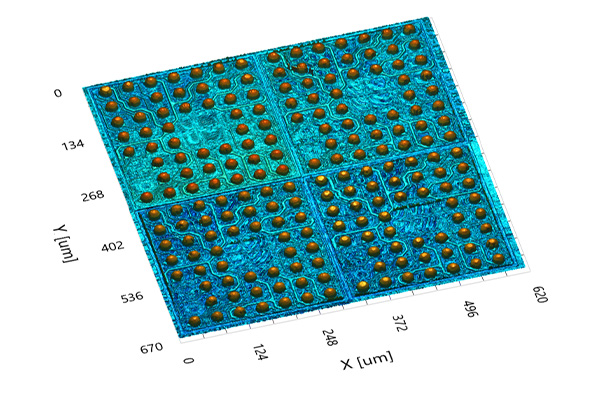
エッチング工程における深さ測定
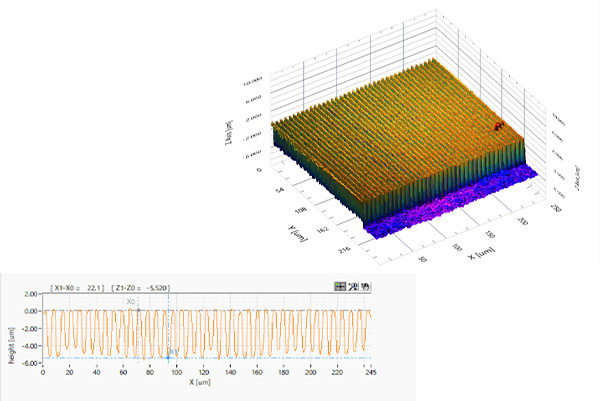
粒子形状観察

標準段差(VLSI)200nm段差測定
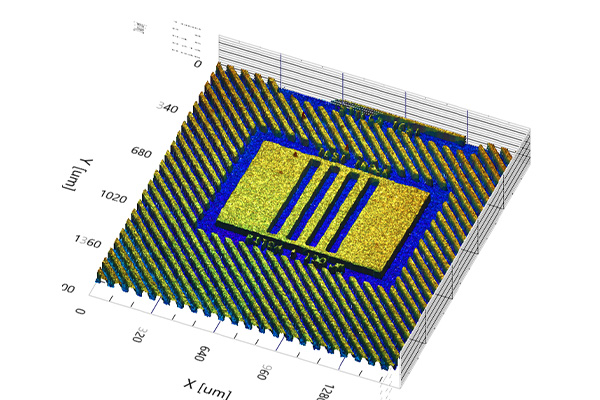
フィルム透過高さ測定機能
「3Dセンサ」に加え、ドライフィルム等の厚みを測定する「膜厚センサ」を搭載したデュアルセンサによる複合測定です。
貼付したドライフィルム越しに溝やエンボス等の高さを測定可能です。
測定精度
- ドライフィルム越しのエンボス高さ測定精度 ±0.1μm
※ドライフィルム有無による測定値の差
※条件による
特長
- 光干渉方式3Dセンサと膜圧センサのデュアルセンサによる複合測定
- 貼り付けされたドライフィルムを剥がすことなく、ドライフィルム越しに溝・エンボス等の高さ測定が可能
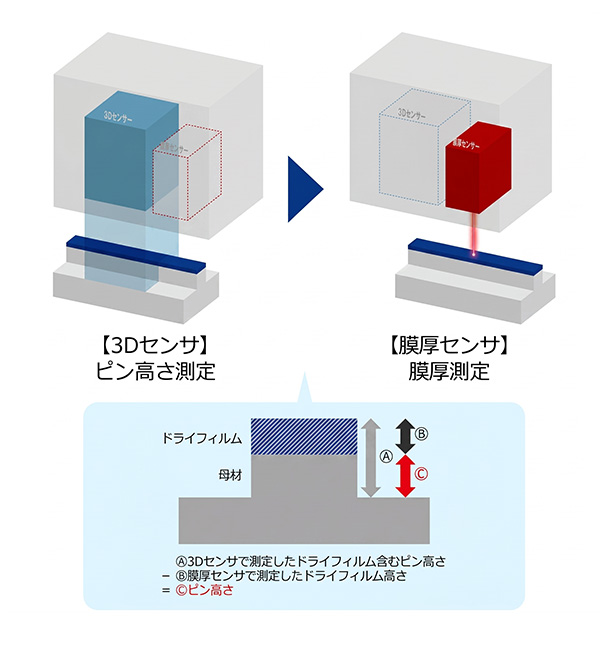
測定点や測定条件をティーチングすることで、より少ない工数で正確な高さ測定が可能です。

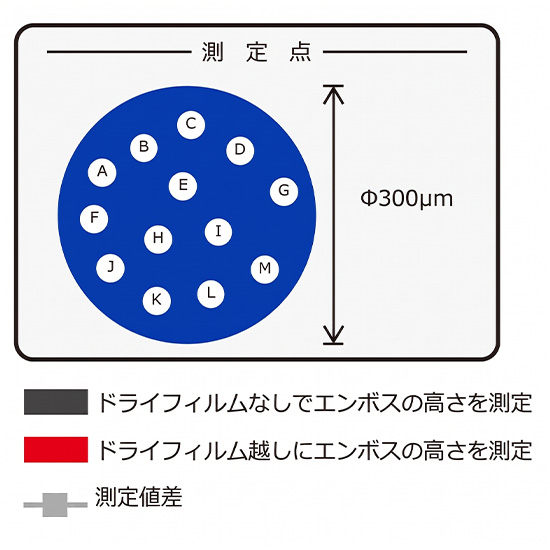
フィルム透過高さ測定例
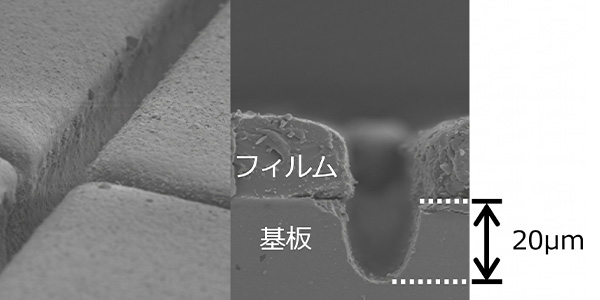
シリコンウェハへのスクライビング加工深さ
フィルム透過高さ測定によるメリット
測定時間を1/9~1/3まで大幅短縮※
※条件による
目視での測定作業や再マスキング、再パターニングが不要となり、測定工程の工数を大きく削減します。
それに伴う加工位置のズレによる加工不良の発生を低減し、歩留まり率を向上します。
精度安定化機能
自動XYステージによって測定位置のズレを検知し、自動でXY位置を補正するパターンマッチング機能を搭載しています。
サンプル毎の位置調整が不要となり、多点測定も高速で完了するためサイクルタイムが向上します。
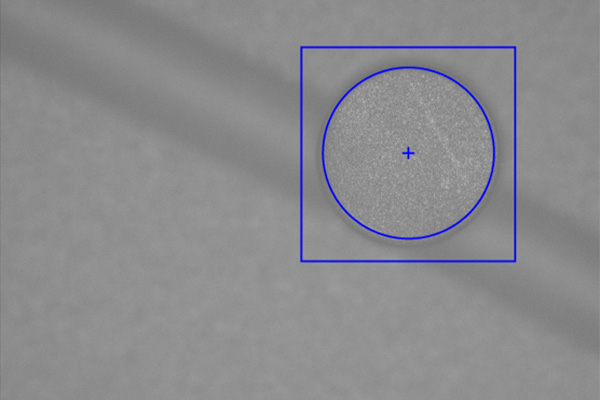
測定精度を向上し、安定化
高い繰り返し精度により、安定的な精密高さ測定を実現します。
また、3Dセンサにより指定エリア内すべての高さ情報を平準化するため、表面の凹凸による測定結果のバラつきを最小化し、点や線ではない面での測定が可能です。

精密高さ測定機「PHM-400」の装置仕様・測定精度
| 装置寸法 | 【本体】(W)1,410×(D)1,470×(H)1,750mm 【PC+制御盤】(W)510×(D)1,100×(H)1,670mm |
|---|---|
| 装置重量 | 【本体】約1,500kg 【PC+制御盤】約200kg |
| 電気容量 | AC100V 50/60Hz 約2.5kVA |
| ユーティリティ | 【乾燥空気】圧力 0.6~0.7MPa 流量 約100L/min(ntp) |
| 有効測定範囲 | (X)400×(Y)400mm |
| 3Dセンサ高さ測定繰り返し性 | 3σ≦0.05μm |
| 3Dセンサ高さ測定精度 | 10μm±0.1μm |
| 膜厚センサ厚さ測定安定性 | 3σ≦0.05μm |
測定テスト
装置導入をご検討いただくにあたって、実際の製品やテストピースでの測定テストを承ります。
※受託測定サービスは承っておりませんので、ご了承ください。



(当社厚木事業所にて)


SP事業部 営業グループ
受付時間/月~金 9:00~12:00、13:00~17:00(祝祭日・弊社休日を除く)